BGA(バンプ)のデジタルマイクロスコープでの観察・測定
第5世代移動通信システム(5G)の普及で、半導体デバイスの微細化、高集積化が進み、製品の検査解析へのニーズが高まっています。
ここでは、デジタルマイクロスコープで観察事例の多い、BGA(バンプ)の観察・測定事例を紹介します。
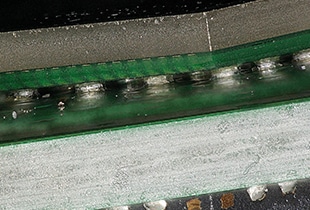
ICパッケージの代表的な種類
ICの集積度が上がるにつれ、表面実装型が主流になっています。また、集積度の高いICには、マトリックスタイプ(BGAタイプ)のパッケージが使用されています。
代表的なICパッケージの種類を下記に示します。
表面実装型:ノンリードタイプパッケージ
- SON (Small Outline Non-leaded package)
-

表面実装パッケージで、リードがなく、かわりに電極パッドが接続用の端子として用意されています。SONは2方向タイプで低ピン数向けのパッケージです。
- QFN (Quad Flat Non-leaded package)
-

表面実装パッケージで、リードがなく、かわりに電極パッドが接続用の端子として用意されています。QFNは4方向タイプのパッケージです。
表面実装型:マトリックスタイプパッケージ
- BGA (Ball Grid Array)
-

パッケージ底面に球形の半田ボールをアレイ状に並べて端子としたものです。
- PGA (Pin Grid Array)
-
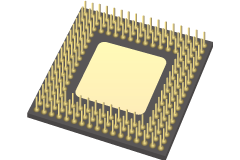
パッケージの底面にピンをアレイ状に並べて端子としたものです。
- LGA (Land Grid Array)
-

パッケージの底面に銅などの電極パッドをアレイ状に並べて端子としたものです。
ICチップを実装する代表的な接合方法
- ワイヤーボンディング接合
-
半導体チップの電極部と、リードフレームや基板上の導体との間を金、アルミニウム、銅などの細いワイヤで接続する方法です。

- フリップチップ接合
-
ICチップを直接プリント基板に接続する方法で、FC-BGA(Flip Chip-BGA)と呼ばれています。ICチップの電極部分にバンプを形成しておき、プリント基板側の電極と接続します。ワイヤーボンディングに比較し、省スペース化が可能になります。

- 左:IC チップ
- 右:フリップ(フェースダウン)
フリップチップ接合のバンプ形成方法の種類
- 半田ボール搭載法
- あらかじめ球状に成形された半田ボールを電極上に搭載し、リフローによってバンプを形成します。ペースト印刷法よりバンプを高くでき、半田ボールの寸法を一定に管理することにより、バンプ高さのばらつきを抑えることができます。
- ペースト印刷法
- 半田ペーストを電極上に印刷し、リフローによってバンプを形成します。スループットは高いですが、高さのばらつきを抑えることが難しくなります。
- メッキ法
- 電解メッキによって半田のバンプを形成します。微細なバンプを形成できますが、スループットは低くなります。
デジタルマイクロスコープによるBGA(バンプ)の観察・測定事例
キーエンスの4Kデジタルマイクロスコープ「VHXシリーズ」を用いたBGA(バンプ)の観察・測定画像の最新事例を紹介します。
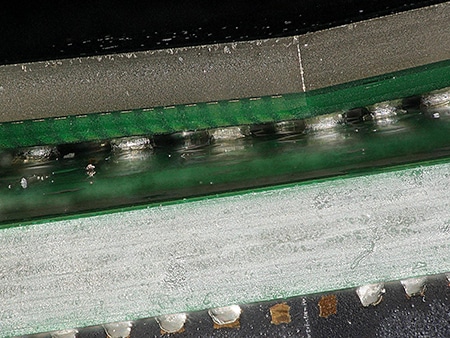
100x リング照明
傾斜観察できますので、基板の隙間からBGAボールが観察できます。
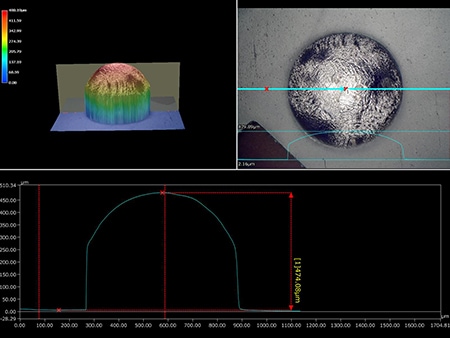
300x ミックス照明(ハレーション除去画像)
ミックス照明とハレーション除去機能を使用することで、
ハレーション無く観察できます。