電子デバイス業界
ワイヤーボンディングのデジタルマイクロスコープでの観察・測定
第5世代移動通信システム(5G)の普及で、半導体デバイスの微細化、高集積化が進み、製品の検査解析へのニーズが高まっています。
ここでは、デジタルマイクロスコープで観察事例の多いワイヤーボンディングの観察・測定事例を紹介します。

ICチップを実装する代表的な接合方法
- ワイヤーボンディング接合
-
半導体チップの電極部と、リードフレームや基板上の導体との間を金、アルミニウム、銅などの細いワイヤで接続する方法です。

- フリップチップ接合
-
ICチップを直接プリント基板に接続する方法で、FC-BGA(Flip Chip-BGA)と呼ばれています。ICチップの電極部分にバンプを形成しておき、プリント基板側の電極と接続します。ワイヤーボンディングに比較し、省スペース化が可能になります。

- 左:IC チップ
- 右:フリップ(フェースダウン)
ワイヤーボンディングの流れ
-
1. キャピラリーと呼ばれる、注射針のように円筒形になったものに金線を通したものを使用します。ワイヤー先端を高電圧でスパークさせて丸くし、その部分を接着させたい電極に接合します。これをBall Bondingや1st Bondingと呼びます。接合は、キャピラリーからの荷重と超音波、そしてボンディングステージの熱によって行います。

- A:金線
- B:ボール
- C:ICチップ
-
2. 1st Bondingが終わり2nd Bonding地点へ移動する際にボンディングワイヤーを連続的に繰り出し、キャピラリーの動きでボンディングワイヤーにループ形状を付けます。

- 3.リード電極との接続では、ボールを形成せずにキャピラリーでワイヤーをつぶして接合します。この接合をStitch Bondingや2nd Bondingと呼びます。
-
4.ワイヤークランパーを閉じ、金線を鋏んで固定した後、キャピラリーを持ち上げワイヤーを切断します。

キャピラリー先端部の名称
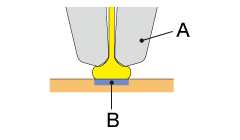
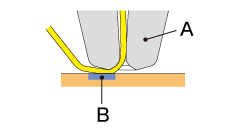
- A:キャピラリー
- B:接合部
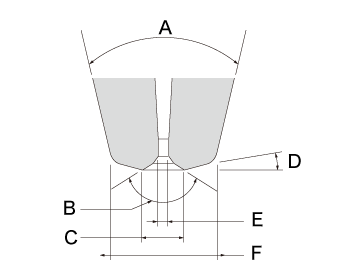
- A:コーン角
- B:チャンファー角
- C:チャンファー径
- D:フェース角
- E:ホール径
- F:先端径
デジタルマイクロスコープによるワイヤーボンディングの観察・測定事例
キーエンスの4Kデジタルマイクロスコープ「VHXシリーズ」を用いたワイヤーボンディングの観察・測定画像の最新事例を紹介します。

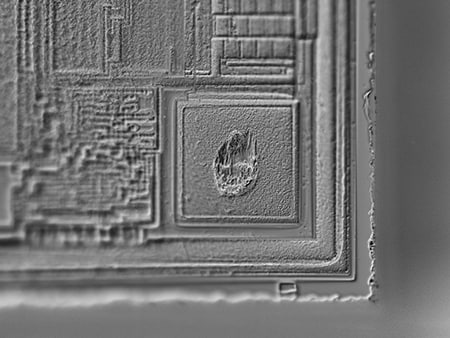
1000x Optical Shadow Effect Mode画像
Optical Shadow Effect Modeを使用することで、
破断面の凹凸が明確に観察できます。


