ウェハの厚みが正確に測れる
Siをはじめ、GaAs、SIC、InP、a-Siなどの半導体を透過できる近赤外SLDを採用。BG(バックグラインド)テープが付いたままでも、ウェハのみの厚みを正確に測定できます。
詳しくは、カタログ(PDF)をダウンロードしてご覧ください。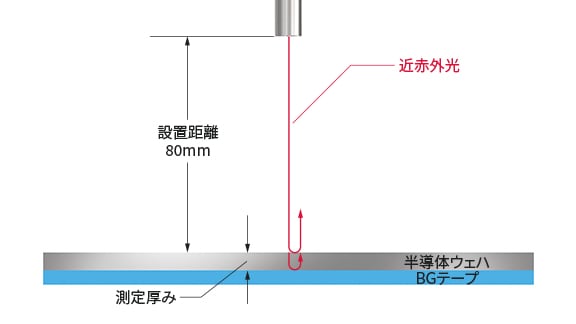
パターンの影響を受けにくい
スポット径を小さくし、スポット内での表面段差を少なくすることで、ウェハ表面のパターンによるばらつき、測定アラームを最小限に抑え込むことができました。
詳しくは、カタログ(PDF)をダウンロードしてご覧ください。パターン付き Si ウェハの厚みプロファイルデータ

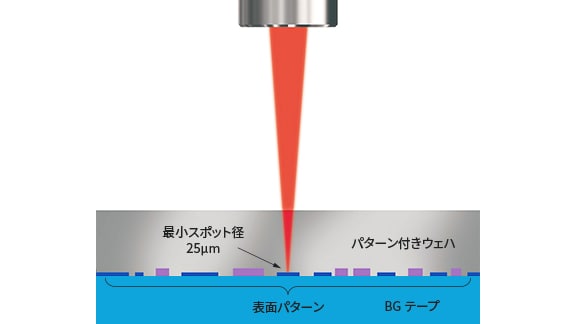
厚みの面内分布を見える化可能
X/Yステージを組み合わせることで、簡単に面内の厚み分布を見える化できます。
詳しくは、カタログ(PDF)をダウンロードしてご覧ください。
ウエハの厚み面内分布イメージ

プロファイル形状測定イメージ図

-
レーザ変位計
- マルチカラーレーザ同軸変位計 CL-3000 シリーズ
- 超高速・高精度レーザ変位計 LK-G5000 シリーズ
- 高速・高精度CCDレーザ変位計 LK-G3000 シリーズ
- マイクロヘッド型 分光干渉レーザ変位計 SI-F シリーズ
- 分光干渉変位タイプ 多層膜厚測定器 SI-T シリーズ